



热门搜索 导热硅脂、低温热固胶、BGA底部填充胶、PUR热熔胶、紫外线光固化胶、导热环氧胶、AB结构胶
作者:信息发布员 来源:东莞市华圳电子科技有限公司 时间:2020/4/26 16:29:06
全球电子制造业正进入一个创新密集和新兴企业快速发展的时期,随着元件封装的飞速发展,越来越多的PBGA、CBGA、CCGA、QFN、0201、01005,03015阻容元件等得到广泛运用,表面贴装技术亦随之快速发展,在其生产过程中,焊接品质越来越受到工程师们的重视。

回流焊技术在电子制造领域并不陌生,我们智能手机内使用的各种PCBA板卡上的元件都是通过这种工艺焊接到线路板上的,SMT回流焊是通过熔化预先放置的焊料面形成焊点,在焊接过程中不再加任何额外焊料的一种焊接方法,通过设备内部的加热电路,将空气或氮气加热到足够高的温度后吹向已经贴好元件的线路板,让元件两侧的锡膏焊料融化后与主板粘结,这种工艺的优势是温度易于控制,焊接过程中还能避免氧化,制造成本也更容易控制。
回流焊已成为SMT的主流工艺,我们常用的智能手机板卡上的元件大都是通过这种工艺焊接到线路板上的 , 是靠热气流对焊点的作用,胶状的焊剂在一定的高温气流下进行物理反应达到SMD的焊接;之所以叫"回流焊"是因为气体在焊机内循环流动产生高温达到焊接及固化目的。
焊接及固化,是电子板组装作业中的重要工序,如果没有很好的掌握它,不但会出现许多“临时故障”还会直接影响焊点的寿命。

▲SMT回流焊温度曲线▲
典型底部填充固化工艺
底部填充技术上世纪七十年代发源于IBM公司,目前已经成为电子制造产业重要的组成部分。起初该技术的应用范围只限于陶瓷基板,直到工业界从陶瓷基板过渡到有机(叠层)基板,底部填充技术才得到大规模应用,并且将有机底部填充材料的使用作为工业标准确定下来。

在电子制造工艺中另一种需要固化的工艺是底部填充工艺,这是将填充材料灌注入芯片与基板之间的空隙中,这是因为芯片与基板材料之间膨胀系数不一致,而填充材料则能保护焊点不受这种应力的影响。还有是球状封顶以及围坝填充技术,这两种技术是用覆盖材料将已焊接的裸芯片加以封装的工艺。
随着芯片针脚密度越来愈高,芯片面积越来愈大点胶逐渐成了保护电路板的重要工艺,在其他工艺水平同等条件下,点胶会显著提升产品可靠性与寿命”。那么点胶为什么会起到保护作用的?

点胶通过对芯片焊球或元器件焊点的保护来避免跌落、挤压、弯折后焊接开裂而引发的功能失效;点胶也具有防水、防光透、密封等不同作用。底部填充胶水添加之后还需要再经过高溫烘烤以加速环氧树脂的固化時间,另外也可以确保晶片底下的充填胶水真的固化,一般环氧樹脂摆放在室溫下虽然也可以慢慢的固化,但至少需要花費24小時以上的時间,根据与空气接触的时间长短而有所不同,有些环氧树脂的成份裡面还会添加一些金屬元素的添加胶水,选用的时候必須要留意其液态及固态时的表面阻抗,否則有机会產生漏电流(current leakage)问题。
过去,底部填充胶在消费类产品中一般不知加固为何物,有何作用,而军工级SSD从芯片开始进行加固,首先会使用底部填充胶对芯片底部进行完全填充,然后加热160°C固化,底部填充胶不仅可以起到PCB和芯片之间粘合剂的作用,还能把芯片管脚之间的空气完全排出,防止日后芯片管脚的氧化,同时,也可以起到防水作用。
近年的消费类智能手机也表现出了不俗的耐摔性,耐跌落的秘诀才被引入于大众的视线里------点胶。厂商对手机关键部件点胶与否,点胶实施到什么程度有多好,都极大程度上决定着手机的稳健与可靠。
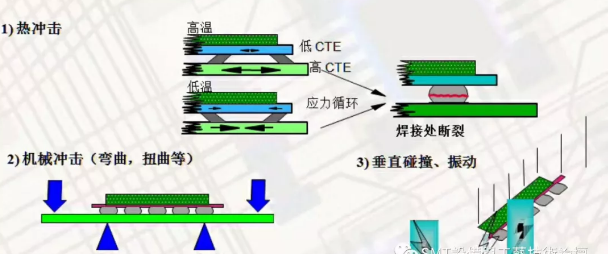
UNDERFILL中文名有很多:底部填充胶、底填胶、下填料、底部填充剂、底填剂、底填料、底充胶等等,基本上称为底部填充剂(胶)应该是最贴近在电子行业实际应用中的名称;是一种单组分环氧密封剂,用于CSP或BGA 底部填充制程。它能形成一致和无缺陷的底部填充层,能有效降低由于硅芯片与基板之间的总体温度膨胀特性不匹配或外力造成的冲击。受热时能快速固化。较低的粘度特性使得其能更好的进行底部填充;较高的流动性加强了其返修的可操作性。
市场对于缩小体积的需求,使CSP(如FLIP CHIP)得到较多应用,这样元件贴装后具有更小的占地面积和更高的信号传递速率。填充或灌胶被用来加强焊点结构使其能抵受住由于硅片与PCB材料的热膨胀系数不一致而产生的应力,一般常会采用上滴或围填法来把晶片用胶封起来。许多这样的封装胶都需要很长的固化时间,对于在线生产的炉子来讲是不现实的,通常会使用成批处理的烘炉,但是垂直烘炉已经被证明可以成功地进行固化过程,并且其温度曲线比普通回流炉更为简单,垂直烘炉使用一个PCB传输系统来扮演缓冲区/堆积区的作用,这样就延长了PCB板在一个小占地面积的烘炉中驻留的时间。
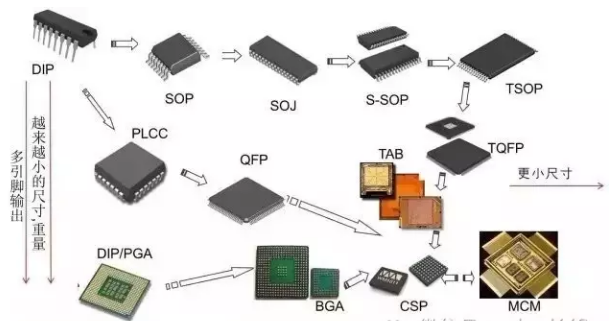
底部填充包封材料起初应用于提高早期氧化铝(Al2O3)基材的倒装芯片的可靠性。在芯片最外围的焊点易疲劳而导致芯片功能失效。相对较小的硅片和基材间的热膨胀差异是芯片在经受热循环时产生这种问题的根源。这样,热循环的温度范围及循环的次数就决定了芯片的使用寿命。在芯片和基板间填充可固化的包封材料,可以很好地把热膨胀差异带来的集中于焊点周围的应力分散到整个芯片所覆盖的范围。
几乎所有这几种封装材料都需要很长的固化时间,所以用在线式连续生产的固化炉是不实际的,平时大家经常使用“批次烘炉”,但垂直烘炉的技术也趋于完善,尤其在加热曲线比回流炉简单时,垂直烘炉完全能够胜任。垂直烘炉使用一个垂直升降的传送系统作为“缓冲与累加器”,每一块PCB都必须通过这一道工序循环。这样的结果就是得到了足够长的固化时间,而同时减少了占地面积。
垂直固化炉加热系统拥有以下优点:
1、极大地缩短设备了长度,提高空间利用率,占地面积小;
2、垂直加热系统传动方式采用步进方式,智能化拓展空间要大。如果采用机械手就可以取消人工手工放板,可以实现多机一人就可以完成供料维护;
3、垂直加热系装置布置远少于水平运输模式,节能效果明显。

▲温度曲线(用户可以调整)▲
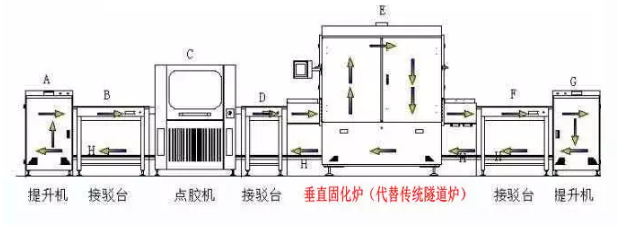
▲垂直固化炉工艺流程▲

▲传统点胶固化方式▲
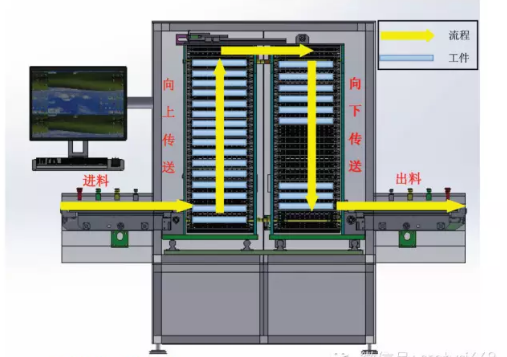
▲垂直固化炉点胶固化方式▲
垂直固化炉全自动入板出板,完全取消离线固化炉需要反复取放产品的人工;
没有了取放产品动作对炉温稳定性产生影响,产品质量一致性好;
采用在运输系统双侧布置加热模块的布局,热量补充速度更快,炉内温度均匀性更好。
在线式垂直固化炉应对die attach, flip chip underfill 和 COB封装等;
使用垂直型固化炉可提高产能和质量同时降低成本。
使用在线式垂直炉实现环氧胶固化工艺在3个方面突显出了极大优势:
相对于离线式固化炉,由于在线式自动进出产品提高了产量,减少了离线式固化炉所需的反复进出板的人工,充分利用车间高度空间,垂直固化炉相比较水平运输的固化线,在同等的产能情况下将设备占地面积大幅度缩小。
相对于离线式固化炉,由于在线式由于无需频繁开启和关闭炉门而节省了时间和热量损失,所以工艺一致性好而保证了产品质量。
由于整个工厂车间,特别是净化房内的装修成本极高,而垂直炉只需要6英尺大的占地面积即可实现4小时的固化工艺,从而节约了装修成本。
底部填充胶的工艺步骤
底部填充胶工艺步骤:烘烤——预热——点胶——垂直固化炉固化——检验。
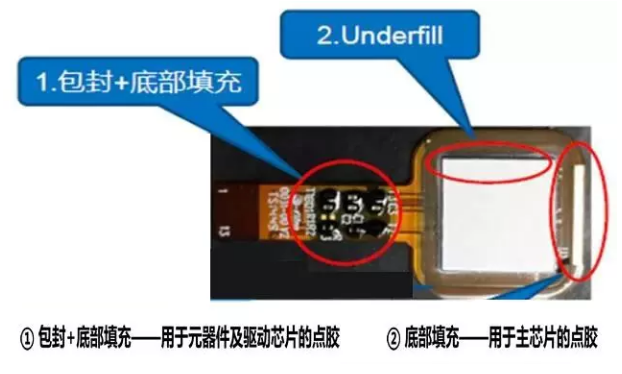
底部填充胶烘烤环节:建议在120—130°C之间,温度过高会直接影响到焊锡球的质量。取样并通过不同时间段进行称量PCBA的重量变化,直到重量丝毫不变为止。
底部填充胶预热环节:这一环节取决于所用填充物的特性。其目的主要是加热使得填充物流动加速。反复的加热势必会使得PCBA质量受到些许影响,所以建议这个环节建议温度不宜过高,建议控制在70°C一下。
具体参数确定方法为:在不同温度下对典型SMA元件实施underfill,测量其完全流过去所需要的时间,根据线体平衡来确定所需要的温度,同时也建议参考填充物供货商的最佳流动所需要的温度做为参数。
底部填充胶点胶环节:通常实施方法有操作人员的手动填充和机器的自动填充。无论是手动和自动,一定需要借助于胶水喷涂控制器,其两大参数为喷涂气压和喷涂时间设定。不同的产品,不同的PCBA的布局,所用的这两个参数不同,使用者可以根据具体产品来具体确定。
1 尽量避免不需要填充的元件被填充 ;
2 绝对禁止填充物对扣屏蔽罩有影响。依据这两个原则可以确定喷涂位置。
底部填充胶固化环节:固化条件往往需要根据填充物的特性来制定profile曲线,这也是选取填充物的一个重要条件。温度过高,仍然会造成对焊锡球的影响,甚至影响到很多其他元器件特性。通常建议采用160°C以下的条件去实施。
主要用于烘干固化SMT红胶,三防漆,FPC油墨,PCB绿油,封装半导体固化等电子行业。
粘接工艺密封胶水的使用,取代了多数的螺丝、胶带,使产品变得更美观。
底部填充的目的,是为了加强BGA与PCB板的贴合强度,分散和降低因震动引起的BGA突点张力和应力。
底部填充胶工艺有四角绑定(如上图)、I型、L型、U型。也有保护围堰工艺,四角绑定底部填充胶的工艺要求。
1、应用在产品为笔记本电脑等产品PCB与BGA的加固贴合。
2、在BGA的四边拐角上点胶水,形成保护堰。
3、加强BGA和PCB的贴合强度。
4、分散和降低因震动所引起的BGA突点张力和应力。
主流电子产品以Apple为代表,不仅关键的字库、CPU、memory等IC实施了点胶,基本上所有的元器件,包含电阻、按键switch等微小元器件也实施了点胶,以保护其焊接点,也起到防水防震的作用。点胶的使用点在扩展,变得越来越多。

业内专家认为,指纹模组生产过程中不管是CSP,还是COB封装方案,在点胶工艺里面,主要是芯片UnderFill胶和芯片周围的封边胶处理,通常用四个边都来点胶的方式,工艺的基本要求,第一点四边都要非常均匀点胶,第二点单边距离小于0.4毫米。其中胶水受环境因素影响非常大,底部不能有空洞或者气泡的情况,UPH要大于1500个。
1、SMT/SMD/SMC电子胶水——贴片红胶,低温固化胶SMT系列贴片胶是环氧树脂(快速热硬化作用)粘合剂,有的具有高剪切稀释粘性特征,所以适用于高速表面贴片组装机(针筒式)点胶机用,特别适用于各种超高速点胶机(如:HDF)。 有的型号的粘度特性和扱摇变性,特别适用于钢网/铜网印胶制程,并能获得良好成形而有效预防PCB板的溢胶现象。产品均按无公害产品的要求,设计开发成要求高温耐热性的无铅(Pb-Free)焊接上适用的产品。低温固化胶是单组份、低温热固化改良型环氧树脂胶粘剂。该产品用于低温固化,并能在极短的时间内在各种材料之间形成最佳粘接力。产品工作性能优良,具有较高的保管稳定性,适用于记忆卡、CCD/CMOS等装置。特别适用于需要低温固化的热敏感元件。
2、COB/COG/COF电子胶水——围堰填充胶,COB邦定黑胶围堰填充胶系列单组分环氧胶,适用于环氧玻璃基板的IC封装之用途,如电池线路保护板等产品。该产品具有优异的耐焊性和耐湿性,低热膨胀系数以减少变形,优异的温度循环性能和较佳的流动性。COB邦定黑胶系单组分环氧树脂胶,是IC邦定之最佳配套产品。专供IC电子晶体的软封装用,适用于各类电子产品,例如计算器、PDA、LCD、仪表等。其特点是流动性较大,易于点胶且胶点高度较低。固化后具有阻燃、抗弯曲、低收缩、低吸潮性等特性,能为IC提供有效保护。此包封剂的设计是经过长时间的温度/湿度/通电等测试和热度循环而研制成的优质产品。
3、 BGA/CSP/WLP电子胶水——底部填充胶底部填充胶(underfill)是单组分环氧密封剂,用于CSP&BGA底部填充制程。它能形成一致和无缺陷的底部填充层,能有效地降低硅芯片与基板之间的总体温度膨胀特性不匹配或外力造成的冲击。较低的黏度特性使其更好的进行底部填充;较高的流动性加强了其返修的可操作性。
4、MC/CA/LE/EP封装材料——导电银胶导电银胶是一种以银粉为介质的单组份环氧导电胶。它具有高纯度、高导电性、低模量的特点,而且工作时效长。该类产品具有极好的常温贮存稳定性,较低的固化温度,离子杂质含量低,固化物有良好的电学和机械性能以及耐温热稳定性等优点。产品成功应用于LED、LCD、石英谐振器、片式钽电解电容器、VFD、IC等方面的导电粘接,适用于印刷或点胶工艺。
5、特种有机硅电子封装材料——特种有机硅灌封/粘结材料许多组装过程中都用到有机硅黏合剂。有机硅的耐候性,对紫外线和高温的抗老化性使得它们在太阳能,照明设备,家用电器等组装行业有着广泛的应用。
上一篇:PUR热熔胶在汽车行业中的应用
下一篇:没有了!